来源: CTIMES
由于技术上仍存在挑战,使得3D IC一直都成为半导体业界想发展,却迟迟到不了的禁区。尽管如此,国际半导体材料协会SEMI仍乐观认为,系统化的半导体技术仍将是主流趋势,这意味着3D IC的发展将不会停下脚步。但在3D IC技术仍未成熟的现阶段,2.5D IC是最好的替代方案。
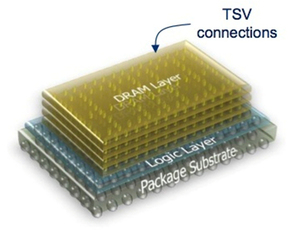
附图 : 3D IC成长主要来自行动装置的记忆体需求增加。3D IC可改善记忆体的性能与稳定度,并减低成本与缩小尺寸。 BigPic:451x346
SEMI认为,目前2.5D IC从设计工具、制造、封装测试等方案都已准备就绪,目前将致力于将量产流程标准化,让2.5D IC在2014年能正式进行量产。至于3D IC,到2016年将有较大幅度的成长空间。
事实上,2.5D IC等于是3D IC在诸多制程与整合问题难以客克服的情况下,半导体业者退而求其次的方案,因此也被某种程度上也被定义为相对过渡的技术,业界仍以实现3D IC为最重要目标。要实现3D IC,就必须利用TSV(矽穿孔)技术,来让晶片互连,完成晶片的异质性堆叠。
然而现阶段TSV针对裸晶如何有效散热并让晶片运作等问题,仍存在挑战。2.5D IC则是让裸晶间采平行排列方式,在中介层进行连结,缩短讯号的延迟时间并提升系统的整体效能。
业界认为,目前2.5D及3D IC制程方案已逐渐成熟,产业面临的最大挑战仍在量产能力的有效提升。包括台积电、日月光、意法、三星、尔必达、美光、Global foundries、IBM、Intel等半导体大厂都已投入3D IC的研发与生产。
SEMI表示,3D IC的主要技术趋势就是多晶片封装,也就是将更多电晶体封装在3D IC中,可加速记忆体与处理器间的沟通。也正由于多晶片封装技术需求增加,使得3D IC市场倍受瞩目。多晶片封装技术将两种以上记忆体晶片透过整合与堆叠设计,封装在同一个BGA封装中,比起两个薄型TSOP封装,还节省70%空间。
TechNavio分析预测,今年起至2016年,全球3D IC市场的年复合成长率为19.7%,成长主要来自行动装置的记忆体需求增加。3D IC可改善记忆体的性能与稳定度,并减低成本与缩小尺寸。










 您当前的位置:
您当前的位置: